如果你是个smt工程师,那你一定用过X-Ray,也用它看过BGA,可是你看来看去BGA的焊球(ball)都一样,你如何判断BGA有没有空焊? 通常来说,一般人使用X-Ray都只能看看焊锡有没短路(short)、少锡、气泡(void),但如果要用来判断BGA的锡球(ball)是否有空焊就有点难,其实如果细心一点的话还是可以找到一点蛛丝马迹来判断是否有空焊。
一般来说X-Ray照出来的影像都只是简单的2D投影画面,用它来检查短路(short)很容易,但用它来检查空焊就难倒了不少人,因为每苛求看起来都是圆的,实在看不出来有没有空焊,虽然近年来也有号称可以照出3D影像的X-Ray,但是所费都不眦啊!而且能否如商家所宣称的那么神奇,实在不敢妄想。
这里分享你一个小撇步,如何用传统的2D平面X-Ray影像判断BGA是否空焊。
BGA锡球变大造成空焊
首先想想同一个BGA IC的锡球应该都是一样的大小,其中如果有些锡球是空焊,有些球是焊锡完整,那这两种焊锡的形状是否会有些不一样?答案是肯定的,试想同样体积的锡球经过压缩后,好的焊锡会有一部份锡球的锡分散到PCB的焊垫(pad)而使焊球变小;有空焊的锡球则不会,锡球经过压缩后反而会使锡球变大。
下图表示同样大小的锡球发生空焊时,锡球的直径反而会变大,当然最好比较一下正常板子的焊球是否都一样大,因为有些板子的设计会造成锡球变得比较小,后面会再详述。
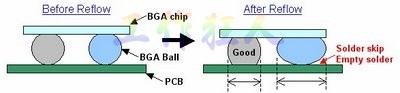
▼下图为实际的例子说明锡球直径变大,表示焊锡空焊(solder skip)。
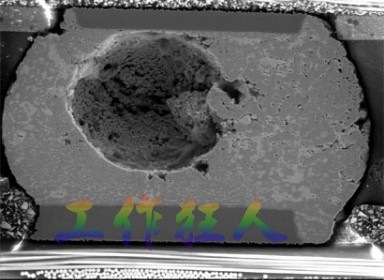
▼从下面这张X-Ray的图片,你可以看得出来哪一颗BGA锡球空焊了吗?运用一下上面教你的方法~

▼现在我画几条直线你再看看是否有发现那一颗BGA的锡球比较大,有空焊的可能?再回去看一下上面那张图,确认看看你没有看走眼。
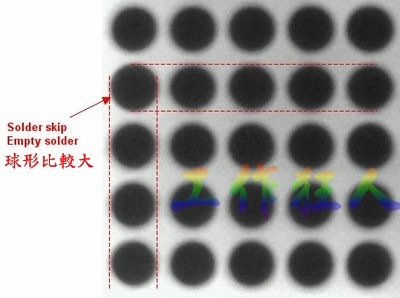
导通孔(vias)导至锡量不足的空焊
另外一种空焊现象是锡量不足,这种现象通常发生在焊垫有导通孔(via)的时候,因为锡球流经回流焊(Reflow)时部分的锡会因为毛细现象(wicking)流进导通孔而造成锡量不足,有时候导通孔在焊垫旁也会造成这样的问题。这时候从X-Ray上看出来的球体就会变小,锡量被导通孔吃到掉太多就会空焊。通常我们不建议导通孔做在焊垫上,焊垫旁的导通孔也要用绿漆(solder mask)盖起来,以后会讨论导通孔在垫(via in pad)的缺点及补救办法。
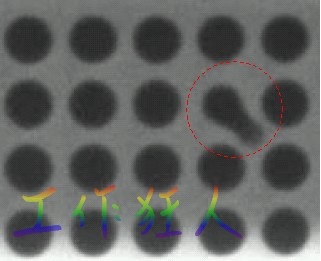
▼这是导通孔(via)摆在焊垫旁(solder pad)的不良设计,这种设计焊锡非常容易流进通孔而造成锡量不足的空焊现象。
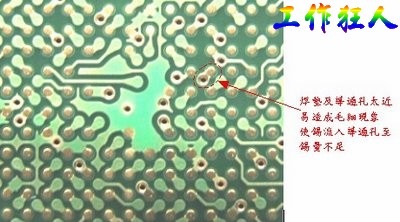
锡球内有气泡产生空焊
还有一种BGA空焊形成的原因是锡球中有气泡(voids),根据IPC7095 7.4.1.6的规范,一般电子业适用于 Class 1 ,其所有气泡的孔直径加起来,不可以超过BGA直径的60%。 如果气泡太大就会造成空焊或焊锡断裂的现象。(2010/11/22更正,一般电子产品应适用于Class 1,而非Class 3,另新增各种等级的解释)
- Class 1:适用于一般消费性电子产品。BGA的气泡要求要不得大于60%(直径)或36%(面积)。
- Class 2:适用于商业/工业用的电子产品。BGA的气泡要求要不得大于42%(直径)或20.25%(面积)。
- Class 3:适用于军用/医疗用的电子产品。BGA的气泡要求要不得大于30%(直径)或9%(面积)。
- 2012-Jul-01更新:根据 IPC-7095B 7.5.1.7规格更新,现在BGA锡球内的气泡准统一要求要不得大于25%(直径)或6.25%(面积)。

▼锡球气泡大到足以影响到焊接的质量,下图是锡球切片后的剖面,可以很明显看到气泡已经有锡球的 1/3 大了。
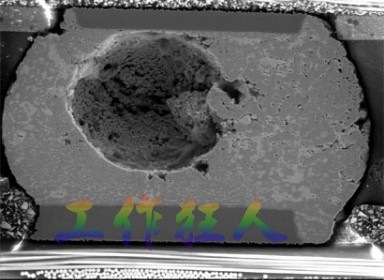
▼这是由X-Ray照出来的锡球气泡,有些气泡已经大到 0.5d 了。